
 Qzone
Qzone
 微博
微博
 微信
微信

近日,根据韩媒ETNews的消息,三星电子AVP先进封装部门正在开发面向AI半导体芯片的“3.3D”先进封装技术。
根据目前放出的消息,这一封装技术将GPU垂直堆叠在LCC(即SRAM缓存)上,两部分键合为一体,类似于三星电子现有X-Cube 3D IC封装技术。
而在GPU+LCC缓存整体与HBM的互联中,3.3D封装技术将GPU+LCC和HBM位于铜RDL重布线中介层上,用硅桥芯片实现裸晶之间的直接连接,而铜RDL 重布线层又位于载板上方。
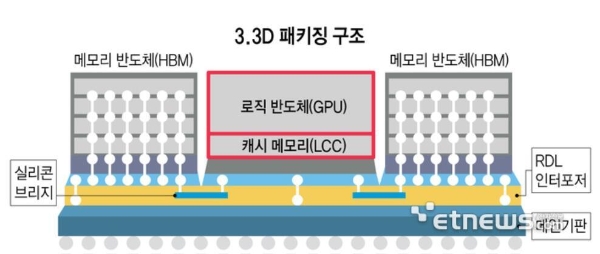
根据三星方面消息,该设计能够在不牺牲芯片设计的前提下,相较完全使用硅中介层的方案,降低22%的生产成本。
该技术有望在2026年第二季度实现量产。

延伸阅读:
















TOM2025-02-14 17:2802-14 17:28
